
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Comprendre le processus complet de fabrication des dispositifs semi-conducteurs
1. Photolithographie
La photolithographie, souvent synonyme de génération de motifs, est l'un des moteurs les plus critiques derrière l'avancement rapide de la technologie des semi-conducteurs, issue des processus de fabrication de plaques photographiques en impression. Cette technique permet la présentation de n'importe quel motif à une échelle micro ou nanométrique en utilisant la résine photosensible et, lorsqu'elle est combinée avec d'autres technologies de traitement, transfère ces motifs sur des matériaux, réalisant ainsi diverses conceptions et concepts de matériaux et de dispositifs semi-conducteurs. La source de lumière utilisée en photolithographie influence directement la précision des motifs, avec des options allant de l'ultraviolet, de l'ultraviolet profond aux rayons X et aux faisceaux d'électrons, chacun correspondant à des niveaux croissants de fidélité du motif dans l'ordre mentionné.
Un flux de processus de photolithographie standard comprend la préparation de la surface, l'adhésion, la cuisson douce, l'exposition, la cuisson post-exposition, le développement, la cuisson dure et l'inspection.
Le traitement de surface est impératif car les substrats absorbent généralement les molécules H2O de l'air, ce qui est préjudiciable à la photolithographie. Par conséquent, les substrats subissent initialement un traitement de déshydratation par cuisson.
Pour les substrats hydrophiles, leur adhésion à la résine photosensible hydrophobe est insuffisante, ce qui peut provoquer un détachement de la résine photosensible ou un désalignement du motif, d'où la nécessité d'un promoteur d'adhésion. Actuellement, l'hexaméthyldisilazane (HMDS) et la tri-méthyl-silyl-diéthyl-amine (TMSDEA) sont des activateurs d'adhérence largement utilisés.
Après le traitement de surface, l'application de la résine photosensible commence. L'épaisseur de la résine photosensible appliquée n'est pas seulement liée à sa viscosité mais est également affectée par la vitesse de dépôt par centrifugation, généralement inversement proportionnelle à la racine carrée de la vitesse de rotation. Après le revêtement, une cuisson douce est effectuée pour évaporer le solvant de la résine photosensible, améliorant ainsi l'adhérence dans un processus connu sous le nom de précuisson.
Une fois ces étapes terminées, l’exposition a lieu. Les photorésists sont classés comme positifs ou négatifs, avec des propriétés opposées après exposition.
Prenons l'exemple du photorésist positif, où le photorésist non exposé est insoluble dans le révélateur, mais devient soluble après exposition. Pendant l'exposition, la source de lumière, traversant un masque à motifs, illumine le substrat revêtu, créant ainsi un motif sur la résine photosensible. Généralement, le substrat doit être aligné avec le masque avant l'exposition pour contrôler avec précision la position d'exposition. La durée d'exposition doit être strictement gérée pour éviter la distorsion du motif. Après l'exposition, une cuisson supplémentaire peut être nécessaire pour atténuer les effets des ondes stationnaires, bien que cette étape soit facultative et puisse être contournée en faveur du développement direct. Le développement dissout la résine photo exposée, transférant avec précision le motif du masque sur la couche de résine photo. Le temps de développement est également critique : un temps de développement trop court conduit à un développement incomplet, tandis qu'un temps trop long entraîne une distorsion des modèles.
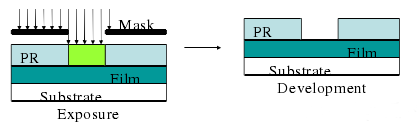
Par la suite, une cuisson dure renforce la fixation du film photorésistant au substrat et améliore sa résistance à la gravure. La température de cuisson dure est généralement légèrement supérieure à celle de la précuisson.
Enfin, une inspection microscopique vérifie si le modèle correspond aux attentes. Une fois le motif transféré sur le matériau par d'autres procédés, la résine photosensible a rempli son objectif et doit être retirée. Les méthodes de décapage comprennent la voie humide (en utilisant des solvants organiques puissants comme l'acétone) et la voie sèche (en utilisant un plasma d'oxygène pour graver le film).
2. Techniques de dopage
Le dopage est indispensable dans la technologie des semi-conducteurs, car il modifie les propriétés électriques des matériaux semi-conducteurs selon les besoins. Les méthodes de dopage courantes comprennent la diffusion thermique et l'implantation ionique.
(1) Implantation ionique
L'implantation ionique dope le substrat semi-conducteur en le bombardant d'ions à haute énergie. Par rapport à la diffusion thermique, elle présente de nombreux avantages. Les ions, sélectionnés par un analyseur de masse, assurent une grande pureté du dopage. Durant toute l'implantation, le substrat reste à température ambiante ou légèrement supérieure. De nombreux films de masquage peuvent être utilisés, tels que le dioxyde de silicium (SiO2), le nitrure de silicium (Si3N4) et la résine photosensible, offrant une grande flexibilité aux techniques de masque auto-aligné. Les doses d'implant sont contrôlées avec précision et la distribution des ions d'impuretés implantés est uniforme dans le même plan, ce qui entraîne une répétabilité élevée.
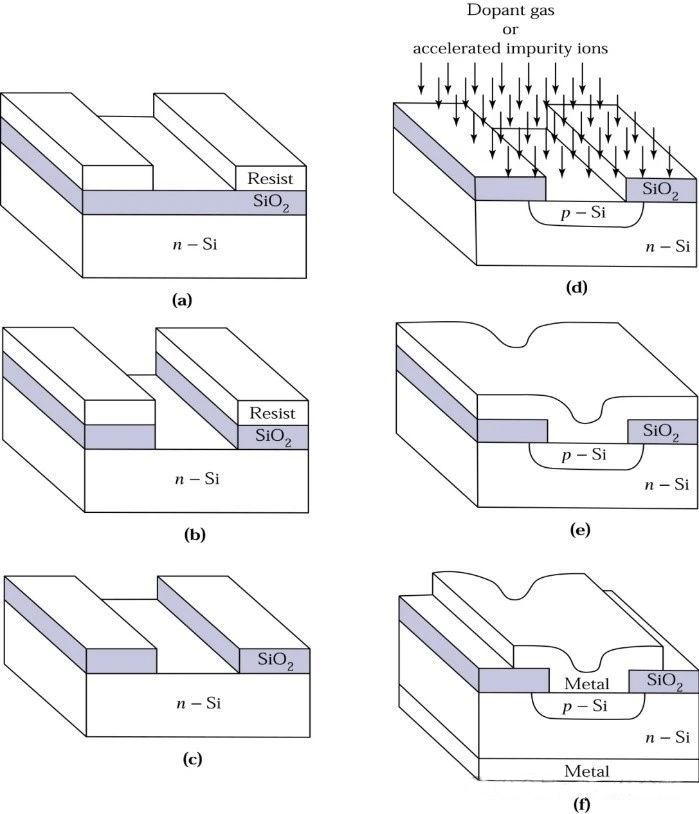
La profondeur d'implantation est déterminée par l'énergie des ions. En régulant l'énergie et la dose, la distribution des ions d'impuretés dans le substrat après l'implantation peut être manipulée. De multiples implantations avec des schémas variés peuvent être réalisées en continu pour obtenir divers profils d'impuretés. Notamment, dans les substrats monocristallins, si la direction d'implantation est parallèle à la direction cristallographique, des effets de canalisation se produisent : certains ions se déplacent le long des canaux, ce qui rend le contrôle de la profondeur difficile.
Pour empêcher la canalisation, l'implantation est généralement réalisée à un angle d'environ 7° par rapport à l'axe principal du substrat monocristallin ou en recouvrant le substrat d'une couche amorphe.
Cependant, l’implantation ionique peut endommager considérablement la structure cristalline du substrat. Les ions de haute énergie, lors d'une collision, transfèrent de l'énergie aux noyaux et aux électrons du substrat, les faisant quitter le réseau et former des paires de défauts interstitiels-vacances. Dans les cas graves, la structure cristalline de certaines régions peut être détruite, formant des zones amorphes.
Les dommages au réseau affectent grandement les propriétés électriques du matériau semi-conducteur, comme la réduction de la mobilité des porteurs ou la durée de vie des porteurs hors équilibre. Plus important encore, la majorité des impuretés implantées occupent des sites interstitiels irréguliers, ne parvenant pas à former un dopage efficace. Par conséquent, la réparation des dommages au réseau post-implantation et l’activation électrique des impuretés sont essentielles.
(2)Traitement thermique rapide (RTP)
Le recuit thermique est la méthode la plus efficace pour corriger les dommages au réseau causés par l’implantation d’ions et l’activation électrique des impuretés. À des températures élevées, les paires de défauts interstitiels-lacunes dans le réseau cristallin du substrat se recombineront et disparaîtront ; les régions amorphes recristallisent également à partir de la limite avec les zones monocristallines via épitaxie en phase solide. Pour empêcher le matériau du substrat de s'oxyder à des températures élevées, le recuit thermique doit être effectué sous vide ou dans une atmosphère de gaz inerte. Le recuit traditionnel prend beaucoup de temps et peut provoquer une redistribution importante des impuretés en raison de la diffusion.
L'avènement deTechnologie RTPrésout ce problème, en réalisant en grande partie la réparation des dommages au réseau et l'activation des impuretés dans une durée de recuit raccourcie.
Selon la source de chaleur,RTPest classé en plusieurs types : balayage par faisceau d'électrons, faisceaux d'électrons et d'ions pulsés, lasers pulsés, lasers à ondes continues et sources de lumière incohérentes à large bande (lampes halogènes, radiateurs en graphite, lampes à arc), ces dernières étant les plus largement utilisées. Ces sources peuvent chauffer le substrat à la température requise en un instant, complétant le recuit en peu de temps et réduisant efficacement la diffusion des impuretés.
3. Techniques de dépôt de film
(1) Dépôt chimique en phase vapeur assisté par plasma (PECVD)
Le PECVD est une forme de technique de dépôt chimique en phase vapeur (CVD) pour le dépôt de film, les deux autres étant le CVD à pression atmosphérique (APCVD) et le CVD à basse pression (LPCVD).
Actuellement, le PECVD est le plus largement appliqué parmi les trois types. Il utilise un plasma radiofréquence (RF) pour initier et entretenir des réactions chimiques à des températures relativement basses, facilitant ainsi le dépôt de films à basse température avec des taux de dépôt élevés. Son schéma d'équipement est tel qu'illustré.
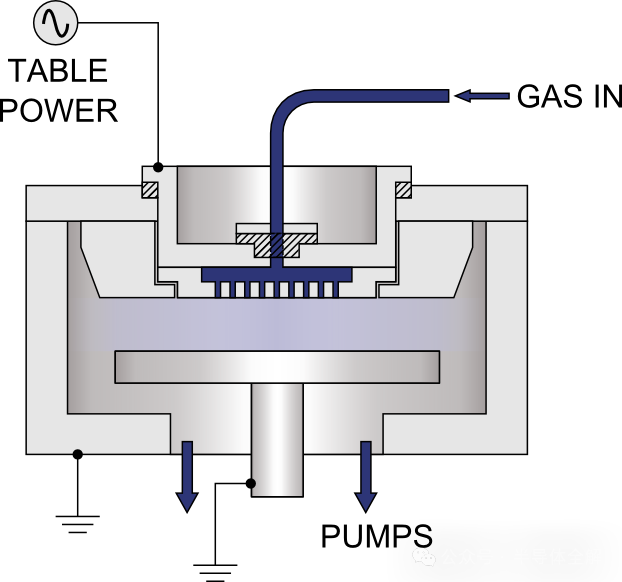
Les films produits via cette méthode présentent des propriétés d'adhérence et électriques exceptionnelles, une microporosité minimale, une uniformité élevée et de robustes capacités de remplissage à petite échelle. Les facteurs affectant la qualité du dépôt PECVD comprennent la température du substrat, le débit de gaz, la pression, la puissance RF et la fréquence.
(2) Pulvérisation
La pulvérisation cathodique est une méthode de dépôt physique en phase vapeur (PVD). Les ions chargés (généralement les ions Argon, Ar+) sont accélérés dans un champ électrique, gagnant de l'énergie cinétique. Ils sont dirigés vers le matériau cible, entrant en collision avec les molécules cibles et les faisant déloger et cracher. Ces molécules possèdent également une énergie cinétique importante et se déplacent vers le substrat et se déposent dessus.

Les sources d'énergie de pulvérisation généralement utilisées comprennent le courant continu (CC) et la radiofréquence (RF), où la pulvérisation CC est directement applicable aux matériaux conducteurs tels que les métaux, tandis que les matériaux isolants nécessitent une pulvérisation RF pour le dépôt du film.
La pulvérisation conventionnelle souffre de faibles taux de dépôt et de pressions de travail élevées, ce qui entraîne une qualité de film inférieure. La pulvérisation magnétron résout ces problèmes de manière plus idéale. Il utilise un champ magnétique externe pour modifier la trajectoire linéaire des ions en une trajectoire hélicoïdale autour de la direction du champ magnétique, allongeant ainsi leur trajectoire et améliorant l’efficacité des collisions avec les molécules cibles, améliorant ainsi l’efficacité de la pulvérisation. Cela se traduit par des taux de dépôt accrus, des pressions de travail réduites et une qualité de film considérablement améliorée.
4. Gravure Techniques
La gravure est classée en modes sec et humide, nommés respectivement en fonction de leur utilisation (ou de leur absence) de solutions spécifiques.
Typiquement, la gravure nécessite la préparation d'une couche de masque (qui peut directement être une résine photosensible) pour protéger les régions non destinées à la gravure.
(1) Gravure à sec
Les types courants de gravure à sec comprennentGravure au plasma à couplage inductif (ICP), gravure par faisceau d'ions (IBE) et gravure ionique réactive (RIE).
Lors de la gravure ICP, le plasma produit par décharge luminescente contient de nombreux radicaux libres hautement chimiquement actifs (atomes libres, molécules ou groupes atomiques), qui réagissent chimiquement avec le matériau cible pour former des produits volatils, réalisant ainsi la gravure.
IBE utilise des ions à haute énergie (ionisés à partir de gaz inertes) pour bombarder directement la surface du matériau cible à graver, ce qui représente un processus physique.
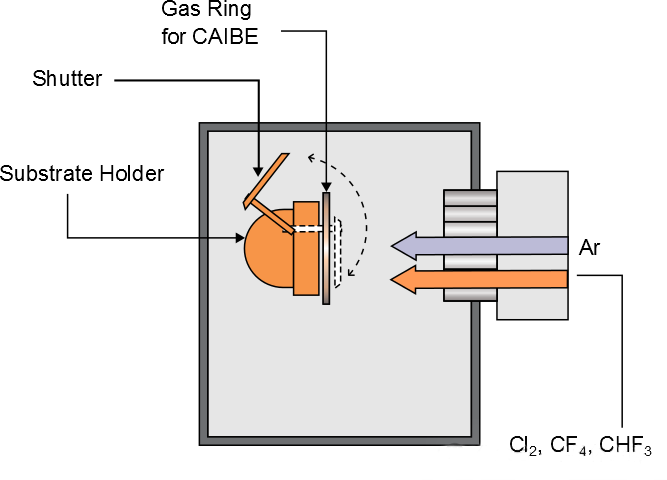
Le RIE est considéré comme une combinaison des deux précédents, remplaçant le gaz inerte utilisé dans l'IBE par le gaz utilisé dans la gravure ICP, constituant ainsi le RIE.
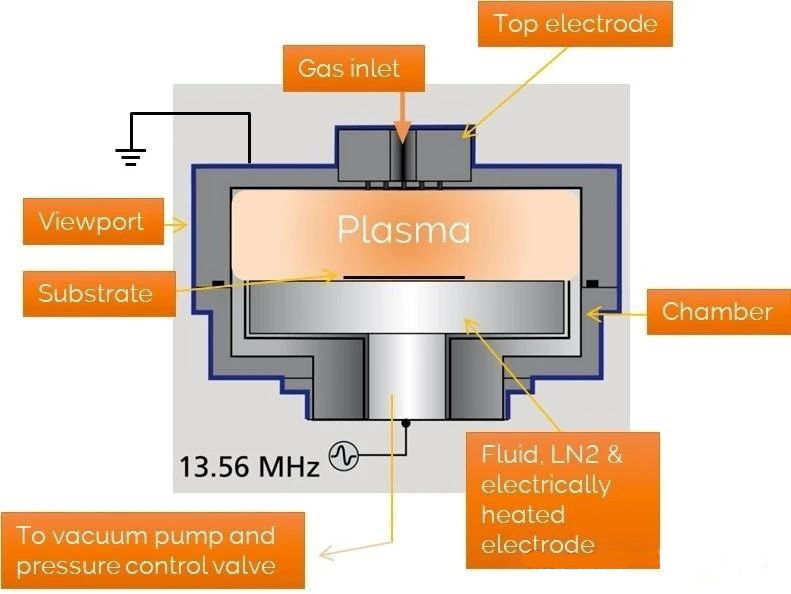
Pour la gravure sèche, la vitesse de gravure verticale dépasse de loin la vitesse latérale, c'est-à-dire qu'elle présente un rapport d'aspect élevé, permettant une réplication précise du motif du masque. Cependant, la gravure sèche grave également la couche de masque, montrant une sélectivité plus faible (le rapport entre les taux de gravure du matériau cible et la couche de masque), en particulier avec l'IBE, qui peut graver de manière non sélective sur la surface du matériau.
(2) Gravure humide
La gravure humide désigne la méthode de gravure obtenue en immergeant le matériau cible dans une solution (agent de gravure) qui réagit chimiquement avec lui.
Cette méthode de gravure est simple, économique et présente une bonne sélectivité mais présente un faible rapport d’aspect. Le matériau situé sous les bords du masque peut être corrodé, ce qui le rend moins précis que la gravure sèche. Pour atténuer les impacts négatifs d'un faible rapport d'aspect, des taux de gravure appropriés doivent être choisis. Les facteurs influençant la vitesse de gravure comprennent la concentration du produit de gravure, le temps de gravure et la température du produit de gravure.**




