
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Dislocation dans les cristaux de SiC
Le substrat SiC peut présenter des défauts microscopiques, tels que la luxation de la vis filetée (TSD), la luxation du bord du filetage (TED), la luxation du plan de base (BPD) et autres. Ces défauts sont causés par des écarts dans la disposition des atomes au niveau atomique.
Les cristaux de SiC se développent généralement de manière à s'étendre parallèlement à l'axe C ou selon un petit angle avec celui-ci, ce qui signifie que le plan C est également appelé plan de base. Il existe deux principaux types de dislocations dans le cristal. Lorsque la ligne de dislocation est perpendiculaire au plan de base, le cristal hérite des dislocations du cristal germe dans le cristal cultivé par épitaxie. Ces luxations sont connues sous le nom de luxations pénétrantes et peuvent être classées en luxations de bord de filetage (TED) et en luxations de vis filetées (TSD) en fonction de l'orientation du vecteur de Bernoulli par rapport à la ligne de luxation. Les luxations, où les lignes de dislocation et les vecteurs de Brönsted se trouvent dans le plan de base, sont appelées dislocations du plan de base (BPD). Les cristaux de SiC peuvent également présenter des dislocations composites, qui sont une combinaison des dislocations ci-dessus.
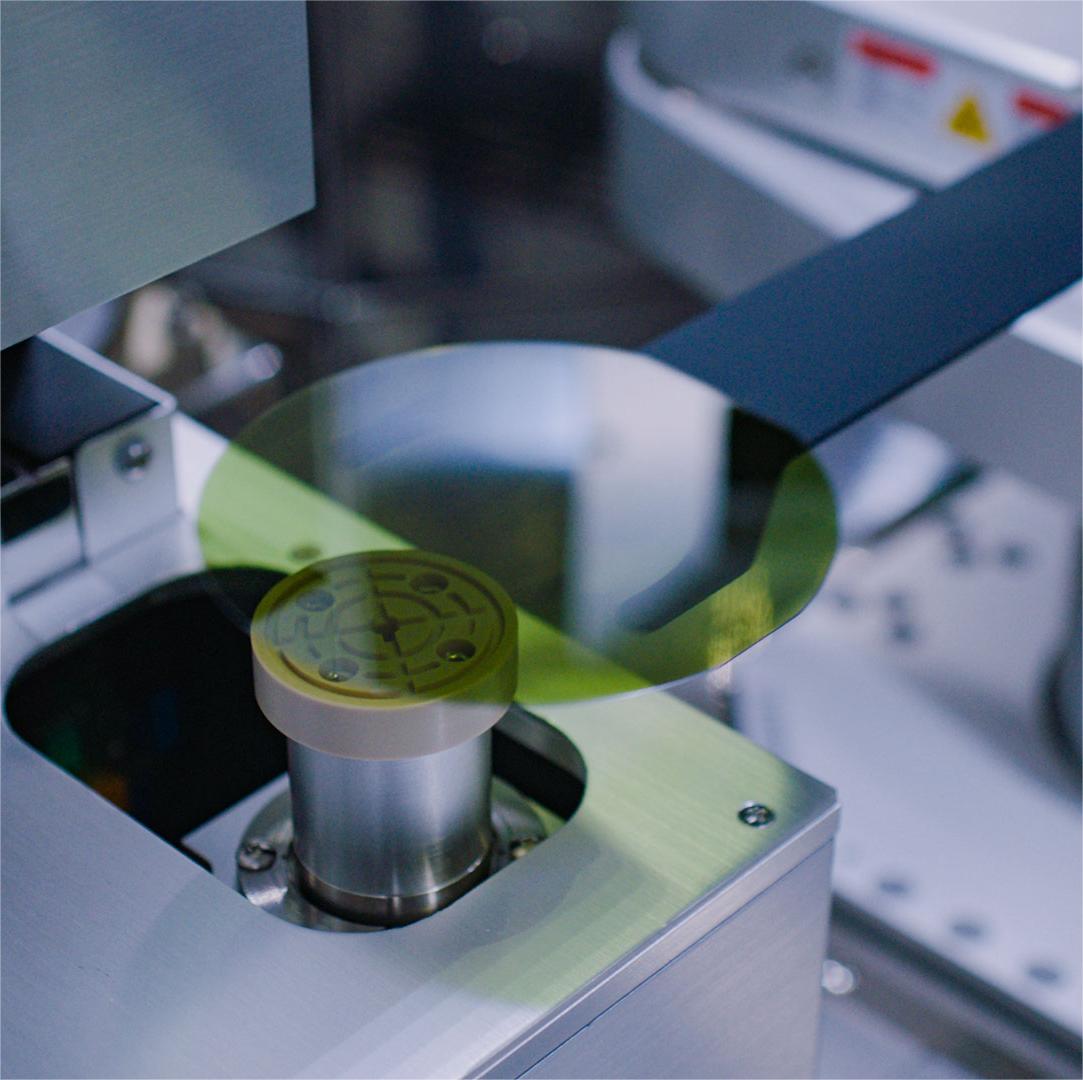
1. TED&TSD
Les luxations filetées (TSD) et les luxations de bord filetées (TED) s'étendent le long de l'axe de croissance [0001] avec différents vecteurs de Burgers de <0001> et 1/3<11-20>, respectivement.
Les TSD et les TED peuvent s'étendre du substrat à la surface de la tranche et produire de petites caractéristiques de surface en forme de creux. Généralement, la densité des TED est d'environ 8 000 à 10 000 1/cm2, soit près de 10 fois celle des TSD.
Au cours du processus de croissance épitaxiale du SiC, le TSD s'étend du substrat à la couche épitaxiale du TSD étendu, peut se transformer en d'autres défauts sur le plan du substrat et se propager le long de l'axe de croissance.
Il a été démontré que lors de la croissance épitaxiale du SiC, le TSD se transforme en défauts de couche d'empilement (SF) ou en défauts de carotte sur le plan du substrat, tandis que le TED dans la couche épitaxiale se transforme en BPD hérité du substrat lors de la croissance épitaxiale.
2. TPB
Les luxations du plan basal (BPD), qui sont situées dans le plan [0001] des cristaux de SiC, ont un vecteur de Burgers de 1/3 < 11-20 >.
Les BPD apparaissent rarement à la surface des plaquettes SiC. Ceux-ci sont généralement concentrés sur le substrat à une densité de 1500 1/cm2, alors que leur densité dans la couche épitaxiale n'est que d'environ 10 1/cm2.
Il est entendu que la densité des BPD diminue avec l'augmentation de l'épaisseur du substrat SiC. Lorsqu’ils sont examinés par photoluminescence (PL), les BPD présentent des caractéristiques linéaires. Au cours du processus de croissance épitaxiale du SiC, le BPD étendu peut être transformé en SF ou TED.
D'après ce qui précède, il est évident que des défauts sont présents dans la tranche de substrat SiC. Ces défauts peuvent être hérités de la croissance épitaxiale de couches minces, ce qui peut provoquer des dommages mortels au dispositif SiC. Cela peut entraîner la perte des avantages du SiC, tels qu'un champ de claquage élevé, une tension inverse élevée et un faible courant de fuite. De plus, cela peut réduire le taux de qualification du produit et poser d’énormes obstacles à l’industrialisation du SiC en raison d’une fiabilité réduite.




