
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Obtention d'une croissance de cristaux SiC de haute qualité grâce au contrôle du gradient de température lors de la phase de croissance initiale
Introduction
Le carbure de silicium (SiC) est un matériau semi-conducteur à large bande interdite qui a suscité une attention particulière ces dernières années en raison de ses performances exceptionnelles dans les applications haute tension et haute température. Les progrès rapides des méthodes de transport physique de vapeur (PVT) ont non seulement amélioré la qualité des monocristaux de SiC, mais ont également permis de fabriquer avec succès des monocristaux de SiC de 150 mm. Cependant, la qualité deplaquettes SiCnécessite encore des améliorations, notamment en termes de réduction de la densité des défauts. Il est bien connu que divers défauts existent dans les cristaux de SiC développés, principalement en raison d'une compréhension insuffisante des mécanismes de formation de défauts au cours du processus de croissance des cristaux de SiC. Des recherches plus approfondies sur le processus de croissance du PVT sont nécessaires pour augmenter le diamètre et la longueur des cristaux de SiC tout en améliorant le taux de cristallisation, accélérant ainsi la commercialisation des dispositifs à base de SiC. Pour obtenir une croissance cristalline SiC de haute qualité, nous nous sommes concentrés sur le contrôle du gradient de température pendant la phase de croissance initiale. Étant donné que les gaz riches en silicium (Si, Si2C) peuvent endommager la surface des germes cristallins pendant la phase de croissance initiale, nous avons établi différents gradients de température au cours de la phase initiale et ajusté à des conditions de température de rapport C/Si constantes pendant le processus de croissance principal. Cette étude explore systématiquement les différentes caractéristiques des cristaux de SiC cultivés dans des conditions de procédé modifiées.
Méthodes expérimentales
La croissance de boules de 4H-SiC de 6 pouces a été réalisée à l'aide de la méthode PVT sur des substrats à face C hors axe de 4 °. Des conditions de traitement améliorées pour la phase de croissance initiale ont été proposées. La température de croissance a été réglée entre 2 300 et 2 400 °C et la pression a été maintenue entre 5 et 20 Torr, dans un environnement d'azote et d'argon gazeux. 6 poucesPlaquettes 4H-SiCont été fabriqués selon des techniques standard de traitement des semi-conducteurs. Leplaquettes SiCont été traités selon différentes conditions de gradient de température dans la phase de croissance initiale et gravés à 600°C pendant 14 minutes pour évaluer les défauts. La densité des piqûres de gravure (EPD) de la surface a été mesurée à l'aide d'un microscope optique (OM). Les valeurs pleine largeur à mi-hauteur (FWHM) et les images cartographiques duPlaquettes SiC de 6 poucesont été mesurés à l’aide d’un système de diffraction des rayons X (DRX) à haute résolution.
Résultats et discussion

Figure 1 : Schéma du mécanisme de croissance des cristaux SiC
Pour obtenir une croissance monocristalline de SiC de haute qualité, il est généralement nécessaire d’utiliser des sources de poudre de SiC de haute pureté, de contrôler avec précision le rapport C/Si et de maintenir une température et une pression de croissance constantes. De plus, il est crucial de minimiser la perte de germes cristallins et de supprimer la formation de défauts de surface sur les germes cristallins pendant la phase de croissance initiale. La figure 1 illustre le schéma du mécanisme de croissance des cristaux de SiC dans cette étude. Comme le montre la figure 1, les vapeurs gazeuses (ST) sont transportées vers la surface du germe cristallin, où elles diffusent et forment le cristal. Certains gaz non impliqués dans la croissance (ST) se désorbent de la surface du cristal. Lorsque la quantité de gaz à la surface des germes cristallins (SG) dépasse la quantité de gaz désorbé (SD), le processus de croissance se poursuit. Par conséquent, le rapport gaz (SG)/gaz (SD) approprié pendant le processus de croissance a été étudié en modifiant la position du serpentin de chauffage RF.
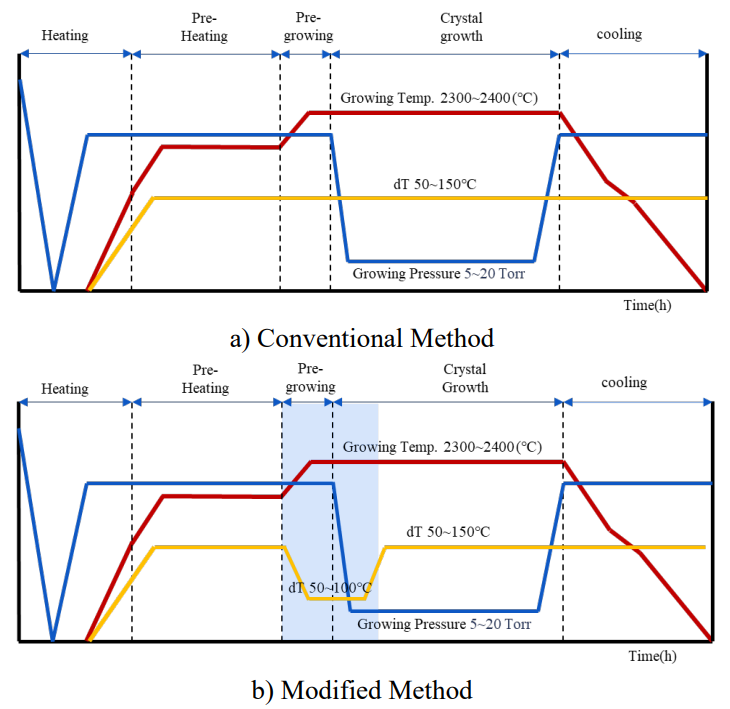
Figure 2 : Schéma des conditions du processus de croissance des cristaux SiC
La figure 2 montre le schéma des conditions du processus de croissance des cristaux de SiC dans cette étude. La température typique du processus de croissance varie de 2 300 à 2 400 °C, avec une pression maintenue entre 5 et 20 Torr. Pendant le processus de croissance, le gradient de température est maintenu à dT = 50 ~ 150 °C ((a) méthode conventionnelle). Parfois, un apport inégal de gaz sources (Si2C, SiC2, Si) peut entraîner des défauts d'empilement, des inclusions polytypes et ainsi dégrader la qualité des cristaux. Par conséquent, dans la phase de croissance initiale, en changeant la position de la bobine RF, dT a été soigneusement contrôlé entre 50 et 100 °C, puis ajusté à dT = 50 et 150 °C pendant le processus de croissance principal ((b) méthode améliorée) . Pour contrôler le gradient de température (dT[°C] = Tbottom-Tupper), la température inférieure a été fixée à 2 300 °C et la température supérieure a été ajustée de 2 270 °C, 2 250 °C, 2 200 °C à 2 150 °C. Le tableau 1 présente les images au microscope optique (OM) de la surface de la boule SiC cultivée dans différentes conditions de gradient de température après 10 heures.
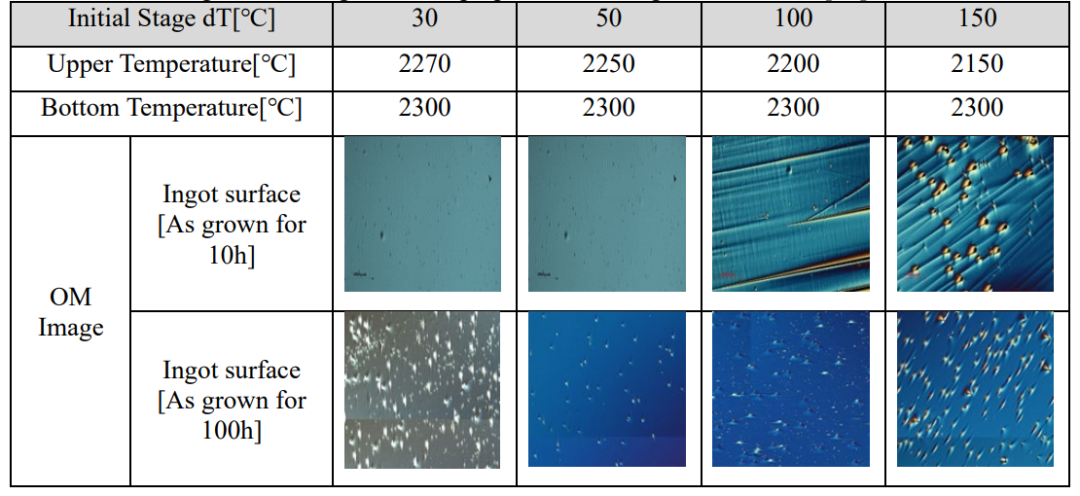
Tableau 1 : Images au microscope optique (OM) de la surface de SiC Boule cultivée pendant 10 heures et 100 heures dans différentes conditions de gradient de température
À un dT initial = 50 °C, la densité de défauts sur la surface de la boule de SiC après 10 heures de croissance était significativement inférieure à celle sous dT = 30 °C et dT = 150 °C. À dT = 30 °C, le gradient de température initial peut être trop faible, entraînant une perte de germes cristallins et la formation de défauts. À l’inverse, à un gradient de température initial plus élevé (dT = 150°C), un état de sursaturation instable peut se produire, conduisant à des inclusions de polytypes et à des défauts dus à des concentrations élevées de lacunes. Cependant, si le gradient de température initial est optimisé, une croissance cristalline de haute qualité peut être obtenue en minimisant la formation de défauts initiaux. Étant donné que la densité de défauts sur la surface de la boule de SiC après 100 heures de croissance était similaire aux résultats après 10 heures, la réduction de la formation de défauts au cours de la phase de croissance initiale est l'étape critique pour obtenir des cristaux de SiC de haute qualité.
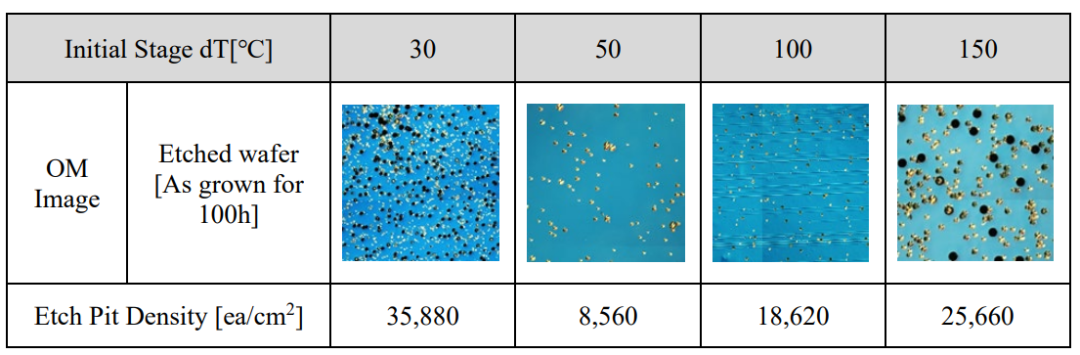
Tableau 2 : Valeurs EPD des boules de SiC gravées dans différentes conditions de gradient de température
Gaufrettespréparés à partir de boules cultivées pendant 100 heures ont été gravés pour étudier la densité de défauts des cristaux de SiC, comme indiqué dans le tableau 2. Les valeurs EPD des cristaux de SiC cultivés sous dT initial = 30 °C et dT = 150 °C étaient de 35 880/cm² et 25 660 /cm², respectivement, alors que la valeur EPD des cristaux de SiC cultivés dans des conditions optimisées (dT=50°C) était considérablement réduite à 8 560/cm².
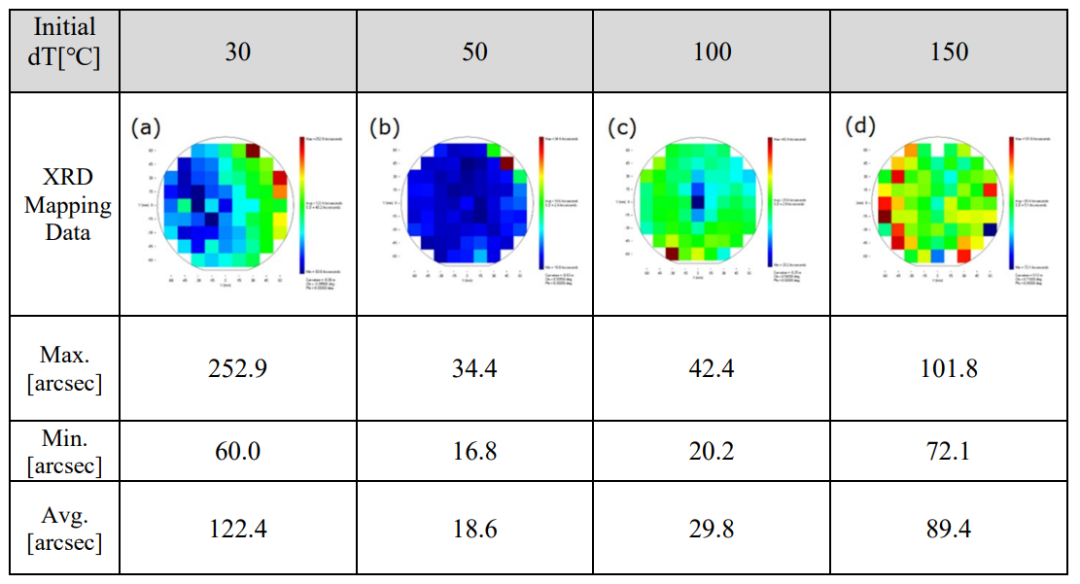
Tableau 3 : Valeurs FWHM et images de cartographie XRD de cristaux de SiC dans différentes conditions de gradient de température initiale
Le tableau 3 présente les valeurs FWHM et les images cartographiques XRD de cristaux de SiC cultivés dans différentes conditions de gradient de température initiale. La valeur FWHM moyenne des cristaux de SiC cultivés dans des conditions optimisées (dT = 50 ° C) était de 18,6 secondes d'arc, nettement inférieure à celle des cristaux de SiC cultivés dans d'autres conditions de gradient de température.
Conclusion
L'effet du gradient de température initial de la phase de croissance sur la qualité des cristaux de SiC a été étudié en contrôlant le gradient de température (dT [° C] = Tbottom-Tupper) en modifiant la position de la bobine. Les résultats ont montré que la densité de défauts sur la surface de la boule de SiC après 10 heures de croissance dans des conditions initiales dT=50°C était significativement inférieure à celle sous dT=30°C et dT=150°C. La valeur FWHM moyenne des cristaux de SiC cultivés dans des conditions optimisées (dT = 50 °C) était de 18,6 secondes d'arc, nettement inférieure à celle des cristaux de SiC cultivés dans d'autres conditions. Cela indique que l'optimisation du gradient de température initial réduit efficacement la formation de défauts initiaux, permettant ainsi une croissance cristalline de SiC de haute qualité.**




