
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe dans la fabrication de puces : un rapport d'actualité professionnel
L'évolution des matériaux semi-conducteurs
Dans le domaine de la technologie moderne des semi-conducteurs, la tendance incessante à la miniaturisation a repoussé les limites des matériaux traditionnels à base de silicium. Pour répondre aux exigences de hautes performances et de faible consommation d'énergie, le SiGe (silicium germanium) est devenu un matériau composite de choix dans la fabrication de puces semi-conductrices en raison de ses propriétés physiques et électriques uniques. Cet article se penche surprocédé d'épitaxiedu SiGe et son rôle dans la croissance épitaxiale, les applications en silicium contraint et les structures Gate-All-Around (GAA).
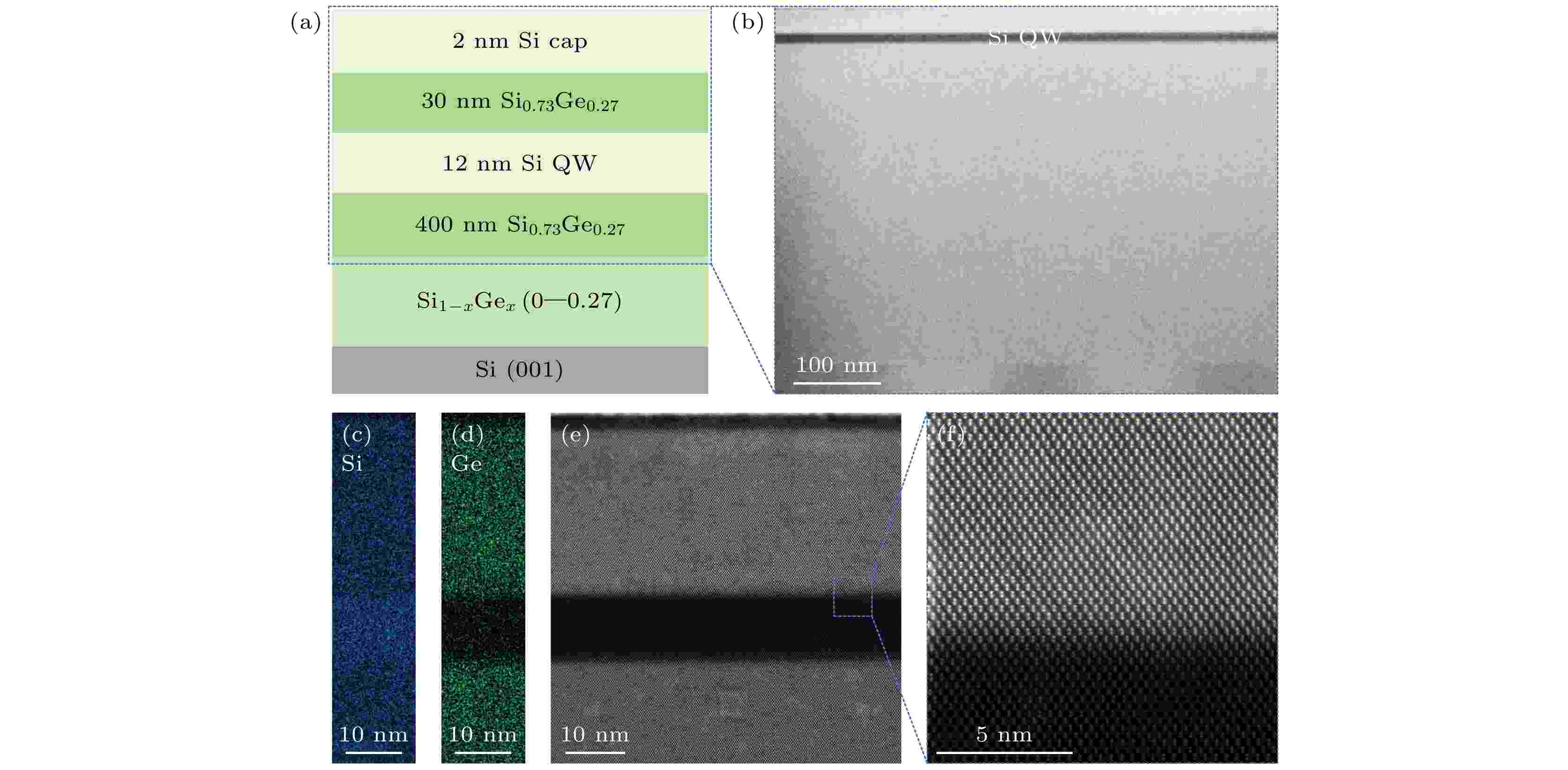
L'importance de l'épitaxie SiGe
1.1 Introduction à l'épitaxie dans la fabrication de puces :
L'épitaxie, souvent abrégée en Epi, fait référence à la croissance d'une couche monocristalline sur un substrat monocristallin présentant le même arrangement de réseau. Cette couche peut être soithomoépitaxial (comme Si/Si)ou hétéroépitaxial (tel que SiGe/Si ou SiC/Si). Diverses méthodes sont utilisées pour la croissance épitaxiale, notamment l'épitaxie par faisceau moléculaire (MBE), le dépôt chimique en phase vapeur sous ultra-vide (UHV/CVD), l'épitaxie atmosphérique et à pression réduite (ATM & RP Epi). Cet article se concentre sur les procédés d'épitaxie du silicium (Si) et du silicium-germanium (SiGe) largement utilisés dans la production de circuits intégrés à semi-conducteurs avec du silicium comme matériau de substrat.
1.2 Avantages de l'épitaxie SiGe :
Incorporer une certaine proportion de germanium (Ge) lors de laprocédé d'épitaxieforme une couche monocristalline SiGe qui non seulement réduit la largeur de la bande interdite, mais augmente également la fréquence de coupure (fT) du transistor. Cela le rend largement applicable dans les appareils haute fréquence pour les communications sans fil et optiques. De plus, dans les processus avancés de circuits intégrés CMOS, la disparité de réseau (environ 4 %) entre Ge et Si introduit une contrainte de réseau, améliorant la mobilité des électrons ou des trous et augmentant ainsi le courant de saturation et la vitesse de réponse du dispositif.
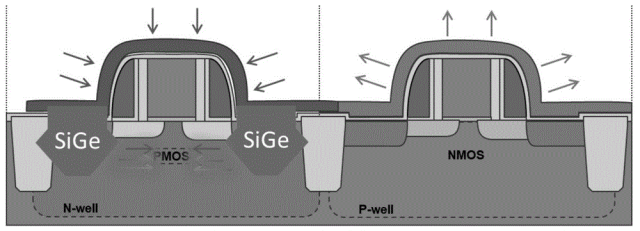
Le flux complet du processus d'épitaxie SiGe
2.1 Prétraitement :
Les tranches de silicium sont prétraitées en fonction des résultats souhaités du processus, impliquant principalement l'élimination de la couche d'oxyde naturelle et des impuretés présentes à la surface de la tranche. Pour les tranches de substrat fortement dopées, il est crucial de déterminer si un backsealing est nécessaire pour réduire l'autodopage lors des opérations ultérieures.croissance par épitaxie.
2.2 Gaz et conditions de croissance :
Gaz de silicium : le silane (SiH₄), le dichlorosilane (DCS, SiH₂Cl₂) et le trichlorosilane (TCS, SiHCl₃) sont les trois sources de silicium gazeux les plus couramment utilisées. SiH₄ convient aux procédés d'épitaxie complète à basse température, tandis que le TCS, connu pour son taux de croissance rapide, est largement utilisé pour la préparation de matériaux épais.épitaxie de siliciumcouches.
Gaz germanium : la germanium (GeH₄) est la principale source d'ajout de germanium, utilisée conjointement avec des sources de silicium pour former des alliages SiGe.
Épitaxie sélective : la croissance sélective est obtenue en ajustant les taux relatifs dedépôt épitaxialet gravure in situ, à l'aide de gaz de silicium contenant du chlore DCS. La sélectivité est due au fait que l'adsorption des atomes de Cl sur la surface du silicium est inférieure à celle sur les oxydes ou les nitrures, facilitant la croissance épitaxiale. SiH₄, dépourvu d'atomes de Cl et doté d'une faible énergie d'activation, est généralement appliqué uniquement aux processus d'épitaxie complète à basse température. Une autre source de silicium couramment utilisée, le TCS, a une faible pression de vapeur et est liquide à température ambiante, nécessitant un barbotage de H₂ pour l'introduire dans la chambre de réaction. Cependant, il est relativement peu coûteux et souvent utilisé en raison de son taux de croissance rapide (jusqu'à 5 μm/min) pour développer des couches d'épitaxie de silicium plus épaisses, largement utilisées dans la production de tranches d'épitaxie de silicium.
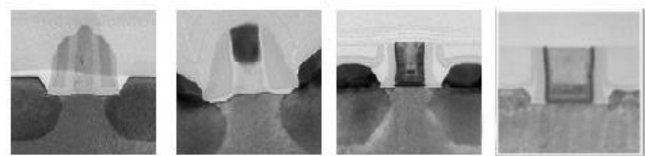
Silicium contraint dans des couches épitaxiales
Pendantcroissance épitaxiale, du Si monocristallin épitaxial est déposé sur une couche de SiGe détendue. En raison de l'inadéquation du réseau entre Si et SiGe, la couche monocristalline de Si est soumise à une contrainte de traction de la couche de SiGe sous-jacente, améliorant considérablement la mobilité électronique dans les transistors NMOS. Cette technologie augmente non seulement le courant de saturation (Idsat), mais améliore également la vitesse de réponse de l'appareil. Pour les dispositifs PMOS, les couches de SiGe sont épitaxiées dans les régions de source et de drain après gravure pour introduire une contrainte de compression sur le canal, améliorant ainsi la mobilité des trous et augmentant le courant de saturation.
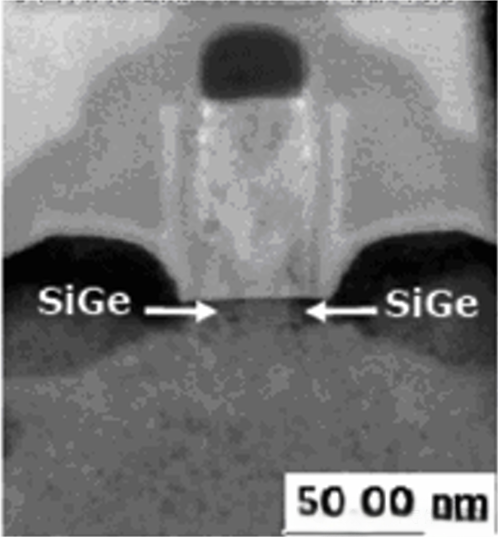
SiGe comme couche sacrificielle dans les structures GAA
Dans la fabrication des transistors à nanofils Gate-All-Around (GAA), les couches de SiGe agissent comme des couches sacrificielles. Les techniques de gravure anisotrope à haute sélectivité, telles que la gravure de couches quasi-atomiques (quasi-ALE), permettent l'élimination précise des couches de SiGe pour former des structures de nanofils ou de nanofeuilles.
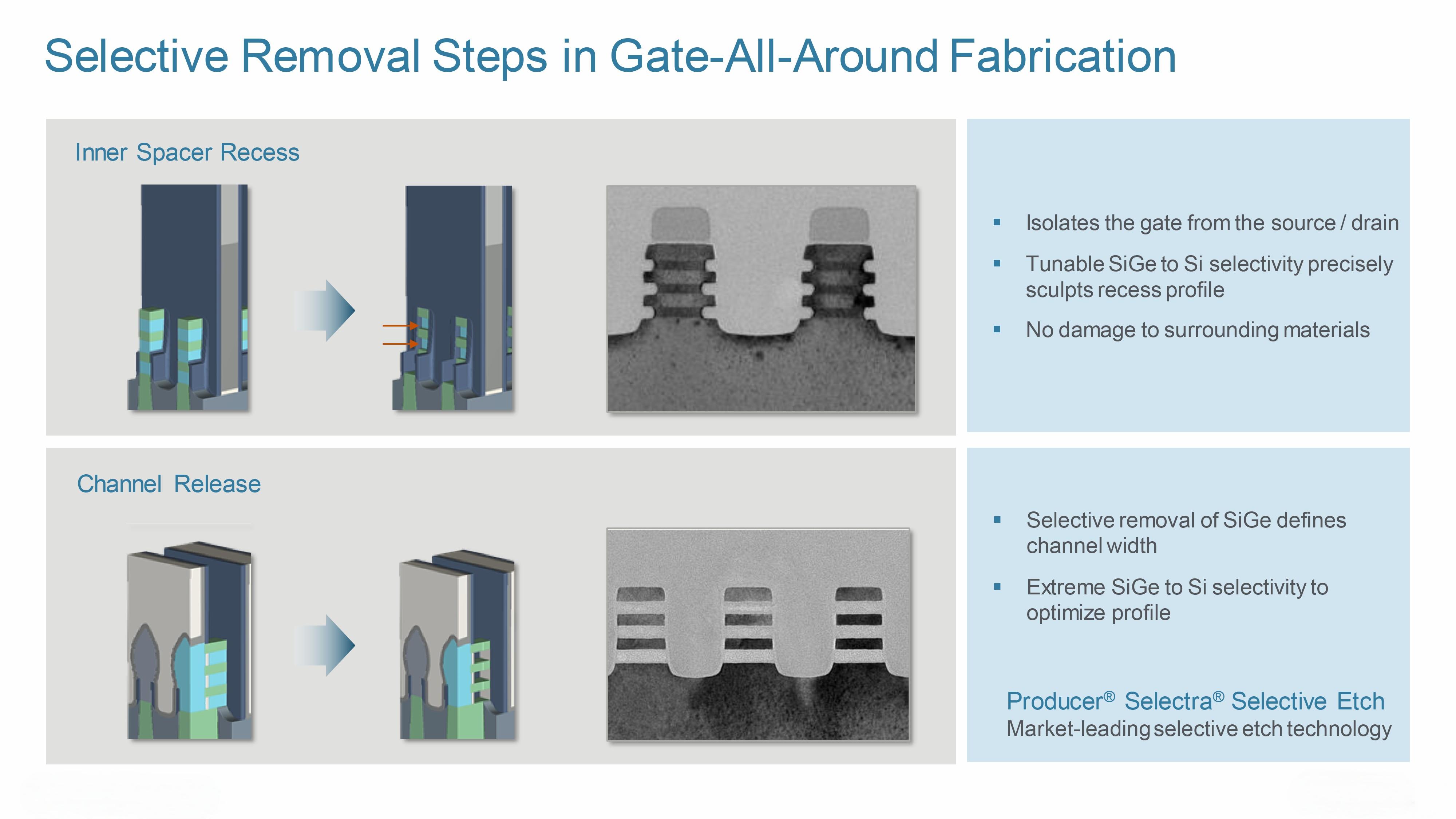
Chez Semicorex, nous sommes spécialisés dansSolutions de graphite revêtues de SiC/TaCappliqué à la croissance épitaxiale du Si dans la fabrication de semi-conducteurs, si vous avez des questions ou avez besoin de détails supplémentaires, n'hésitez pas à nous contacter.
Téléphone : +86-13567891907
Courriel : sales@semicorex.com




