
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Technologie de gravure sélective SiGe et Si
Le Gate-All-Around FET (GAAFET), en tant qu'architecture de transistor de nouvelle génération sur le point de remplacer le FinFET, a suscité une attention considérable pour sa capacité à fournir un contrôle électrostatique supérieur et des performances améliorées dans des dimensions plus petites. Une étape critique dans la fabrication des GAAFET de type n implique la haute sélectivitégravured'empilements SiGe:Si avant le dépôt des espaceurs internes, générant des nanofeuilles de silicium et libérant des canaux.

Cet article se penche sur la sélectiontechnologies de gravureimpliqué dans ce processus et introduit deux nouvelles méthodes de gravure – la gravure sans plasma de gaz hautement oxydant et la gravure par couche atomique (ALE) – qui offrent de nouvelles solutions pour atteindre une précision et une sélectivité élevées dans la gravure SiGe.
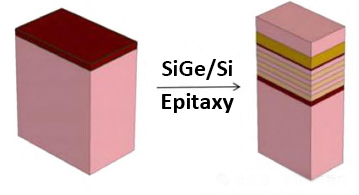
Couches de super-réseau SiGe dans les structures GAA
Dans la conception des GAAFET, pour améliorer les performances du dispositif, des couches alternées de Si et de SiGe sontcroissance épitaxiée sur un substrat de silicium, formant une structure multicouche connue sous le nom de super-réseau. Ces couches de SiGe ajustent non seulement la concentration de porteurs mais améliorent également la mobilité électronique en introduisant une contrainte. Cependant, lors des étapes ultérieures du processus, ces couches de SiGe doivent être éliminées avec précision tout en conservant les couches de silicium, ce qui nécessite des technologies de gravure hautement sélectives.
Méthodes de gravure sélective de SiGe
Gravure sans plasma à haute teneur en gaz oxydant
La sélection du gaz ClF3 : Cette méthode de gravure utilise des gaz hautement oxydants avec une sélectivité extrême, tels que ClF3, atteignant un rapport de sélectivité SiGe:Si de 1 000 à 5 000. Il peut être réalisé à température ambiante sans causer de dommages au plasma.
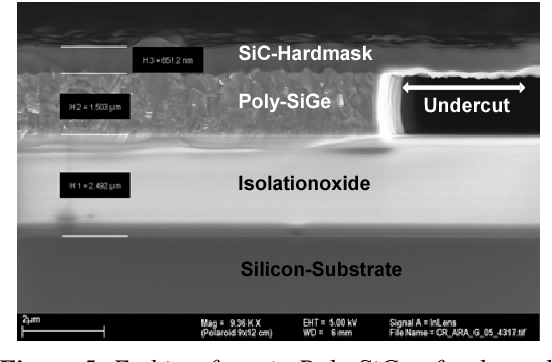
Efficacité à basse température : la température optimale est d'environ 30 °C, ce qui permet une gravure hautement sélective dans des conditions de basse température, évitant ainsi des augmentations supplémentaires du budget thermique, ce qui est crucial pour maintenir les performances du dispositif.
Milieu sec : L'ensembleprocessus de gravureest réalisé dans des conditions complètement sèches, éliminant ainsi le risque d’adhérence de la structure.
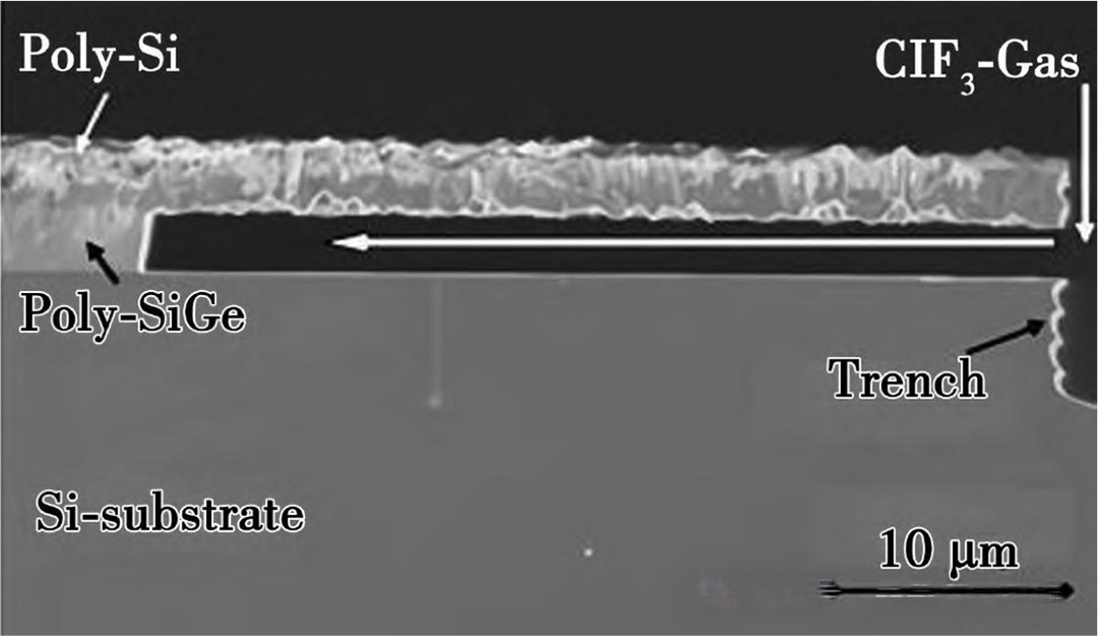
Gravure de couche atomique (ALE)
Caractéristiques autolimitantes : ALE est un cycle cyclique en deux étapestechnologie de gravure, où la surface du matériau à graver est d'abord modifiée, puis la couche modifiée est retirée sans affecter les parties non modifiées. Chaque étape est auto-limitée, garantissant une précision allant jusqu’à supprimer seulement quelques couches atomiques à la fois.
Gravure cyclique : les deux étapes susmentionnées sont répétées à plusieurs reprises jusqu'à ce que la profondeur de gravure souhaitée soit atteinte. Ce processus permet à l'ALE d'atteindregravure de précision au niveau atomiquedans des cavités de petite taille sur les parois intérieures.

Chez Semicorex, nous sommes spécialisés dansSolutions de graphite revêtues de SiC/TaCappliqué aux processus de gravure dans la fabrication de semi-conducteurs, si vous avez des questions ou avez besoin de détails supplémentaires, n'hésitez pas à nous contacter.
Téléphone : +86-13567891907
Courriel : sales@semicorex.com




