
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Présentation du transport physique de vapeur (PVT)
Les caractéristiques propres du SiC déterminent que sa croissance monocristalline est plus difficile. En raison de l'absence de phase liquide Si:C = 1:1 à pression atmosphérique, le processus de croissance plus mature adopté par le courant dominant de l'industrie des semi-conducteurs ne peut pas être utilisé pour développer la méthode de croissance plus mature - méthode de traction droite, creuset descendant. méthode et autres méthodes de croissance. Après des calculs théoriques, ce n'est que lorsque la pression est supérieure à 105 atm et la température est supérieure à 3 200 ℃ que nous pouvons obtenir le rapport stœchiométrique de la solution Si:C = 1:1. La méthode pvt est actuellement l’une des méthodes les plus courantes.
La méthode PVT nécessite peu d'équipement de croissance, un processus simple et contrôlable, et le développement technologique est relativement mature et a déjà été industrialisé. La structure de la méthode PVT est présentée dans la figure ci-dessous.
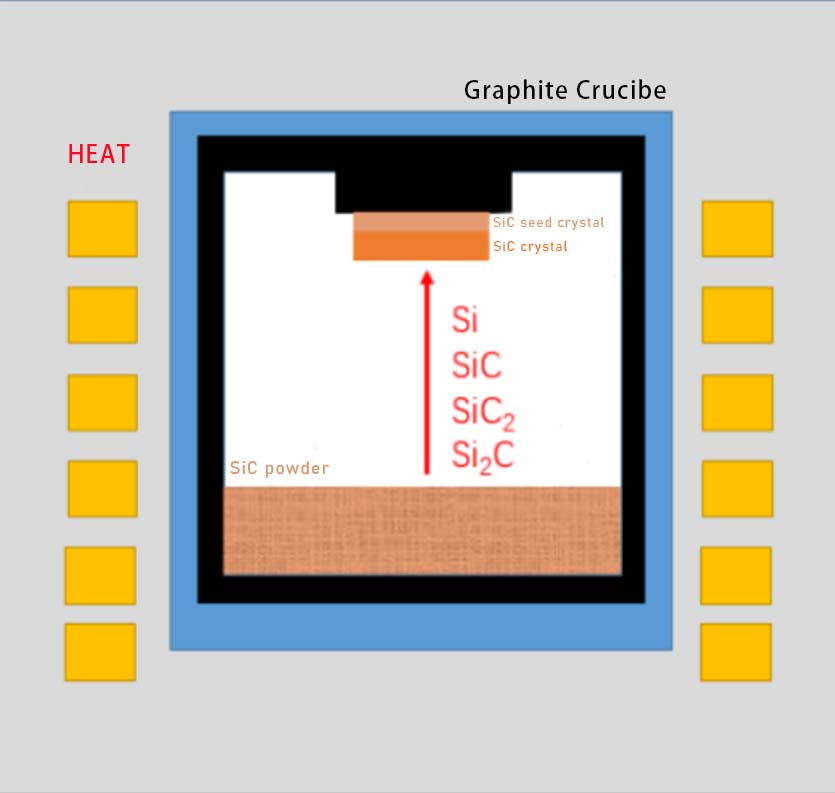
La régulation du champ de température axial et radial peut être réalisée en contrôlant les conditions de conservation de la chaleur externe du creuset en graphite. La poudre de SiC est placée au fond du creuset en graphite à température plus élevée, et le cristal germe de SiC est fixé au sommet du creuset en graphite à température plus basse. La distance entre la poudre et les germes cristallins est généralement contrôlée à plusieurs dizaines de millimètres pour éviter tout contact entre le monocristal en croissance et la poudre.
Le gradient de température est généralement compris entre 15 et 35 °C/cm. Un gaz inerte à une pression de 50 à 5 000 Pa est retenu dans le four pour augmenter la convection. La poudre de SiC est chauffée à 2 000-2 500 °C par différentes méthodes de chauffage (chauffage par induction et chauffage par résistance, l'équipement correspondant étant un four à induction et un four à résistance), et la poudre brute se sublime et se décompose en composants en phase gazeuse tels que Si, Si2C. , SiC2, etc., qui sont transportés vers l'extrémité du germe cristallin par convection gazeuse, et les cristaux de SiC sont cristallisés sur les germes cristallins pour obtenir une croissance monocristalline. Son taux de croissance typique est de 0,1 à 2 mm/h.
À l'heure actuelle, la méthode PVT a été développée et mûrie et peut réaliser la production en série de centaines de milliers de pièces par an, et sa taille de traitement a été réalisée à 6 pouces et se développe maintenant à 8 pouces, et il existe également des entreprises utilisant la réalisation des échantillons de puces de substrat de 8 pouces. Cependant, la méthode PVT présente toujours les problèmes suivants :
- La technologie de préparation de substrats SiC de grande taille est encore immature. Étant donné que la méthode PVT ne peut être utilisée que dans la longueur longitudinale et l'épaisseur, il est difficile de réaliser l'expansion transversale. Pour obtenir des plaquettes SiC de plus grand diamètre, il faut souvent investir d'énormes sommes d'argent et d'efforts, et avec la taille actuelle des plaquettes SiC qui continue de croître, cette difficulté ne fera qu'augmenter progressivement. (Identique au développement du Si).
- Le niveau actuel de défauts sur les substrats SiC développés par la méthode PVT est encore élevé. Les dislocations réduisent la tension de blocage et augmentent le courant de fuite des dispositifs SiC, ce qui affecte l'application des dispositifs SiC.
- Les substrats de type P sont difficiles à préparer par PVT. Actuellement, les dispositifs SiC sont principalement des dispositifs unipolaires. Les futurs dispositifs bipolaires haute tension nécessiteront des substrats de type P. L'utilisation d'un substrat de type P permet de réaliser la croissance d'une épitaxie de type N, tandis que la croissance d'une épitaxie de type P sur un substrat de type N présente une mobilité de porteur plus élevée, ce qui peut encore améliorer les performances des dispositifs SiC.




